
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
8-इंच सिलिकॉन कार्बाइड सिंगल क्रिस्टल ग्रोथ फर्नेस तकनीक पर आधारित
2024-07-11
उच्च तापमान, उच्च आवृत्ति, उच्च शक्ति और उच्च वोल्टेज उपकरण बनाने के लिए सिलिकॉन कार्बाइड आदर्श सामग्रियों में से एक है। उत्पादन दक्षता में सुधार और लागत कम करने के लिए, बड़े आकार के सिलिकॉन कार्बाइड सब्सट्रेट की तैयारी एक महत्वपूर्ण विकास दिशा है। की प्रक्रिया आवश्यकताओं को लक्ष्य करना8-इंच सिलिकॉन कार्बाइड (एसआईसी) सिंगल क्रिस्टल ग्रोथसिलिकॉन कार्बाइड भौतिक वाष्प परिवहन (पीवीटी) विधि के विकास तंत्र का विश्लेषण किया गया, हीटिंग सिस्टम (टीएसी गाइड रिंग, टीएसी लेपित क्रूसिबल,TaC लेपित छल्ले, TaC कोटेड प्लेट, TaC कोटेड थ्री-पंखुड़ी रिंग, TaC कोटेड थ्री-पेटल क्रूसिबल, TaC कोटेड होल्डर, पोरस ग्रेफाइट, सॉफ्ट फेल्ट, रिजिड फेल्ट SiC-कोटेड क्रिस्टल ग्रोथ ससेप्टर और अन्यSiC सिंगल क्रिस्टल ग्रोथ प्रोसेस स्पेयर पार्ट्सVeTek सेमीकंडक्टर द्वारा प्रदान किया जाता है), सिलिकॉन कार्बाइड सिंगल क्रिस्टल ग्रोथ फर्नेस के क्रूसिबल रोटेशन और प्रक्रिया पैरामीटर नियंत्रण तकनीक का अध्ययन किया गया, और थर्मल फील्ड सिमुलेशन विश्लेषण और प्रक्रिया प्रयोगों के माध्यम से 8-इंच क्रिस्टल सफलतापूर्वक तैयार और विकसित किए गए।
0 परिचय
सिलिकॉन कार्बाइड (SiC) तीसरी पीढ़ी के अर्धचालक सामग्रियों का एक विशिष्ट प्रतिनिधि है। इसमें बड़ी बैंडगैप चौड़ाई, उच्च ब्रेकडाउन विद्युत क्षेत्र और उच्च तापीय चालकता जैसे प्रदर्शन लाभ हैं। यह उच्च तापमान, उच्च दबाव और उच्च आवृत्ति क्षेत्रों में अच्छा प्रदर्शन करता है, और अर्धचालक सामग्री प्रौद्योगिकी के क्षेत्र में मुख्य विकास दिशाओं में से एक बन गया है। नई ऊर्जा वाहनों, फोटोवोल्टिक बिजली उत्पादन, रेल परिवहन, स्मार्ट ग्रिड, 5जी संचार, उपग्रह, रडार और अन्य क्षेत्रों में इसकी व्यापक अनुप्रयोग आवश्यकताएं हैं। वर्तमान में, सिलिकॉन कार्बाइड क्रिस्टल का औद्योगिक विकास मुख्य रूप से भौतिक वाष्प परिवहन (पीवीटी) का उपयोग करता है, जिसमें बहु-चरण, बहु-घटक, एकाधिक ताप और द्रव्यमान स्थानांतरण और मैग्नेटो-इलेक्ट्रिक ताप प्रवाह इंटरैक्शन की जटिल बहु-भौतिक क्षेत्र युग्मन समस्याएं शामिल हैं। इसलिए, पीवीटी विकास प्रणाली का डिज़ाइन कठिन है, और प्रक्रिया पैरामीटर माप और नियंत्रण के दौरानक्रिस्टल विकास प्रक्रियाकठिन है, जिसके परिणामस्वरूप विकसित सिलिकॉन कार्बाइड क्रिस्टल और छोटे क्रिस्टल आकार के गुणवत्ता दोषों को नियंत्रित करने में कठिनाई होती है, जिससे सब्सट्रेट के रूप में सिलिकॉन कार्बाइड वाले उपकरणों की लागत अधिक रहती है।
सिलिकॉन कार्बाइड विनिर्माण उपकरण सिलिकॉन कार्बाइड प्रौद्योगिकी और औद्योगिक विकास की नींव है। सिलिकॉन कार्बाइड सिंगल क्रिस्टल ग्रोथ फर्नेस का तकनीकी स्तर, प्रक्रिया क्षमता और स्वतंत्र गारंटी बड़े आकार और उच्च उपज की दिशा में सिलिकॉन कार्बाइड सामग्री के विकास की कुंजी है, और तीसरी पीढ़ी के सेमीकंडक्टर उद्योग को चलाने वाले मुख्य कारक भी हैं। कम लागत और बड़े पैमाने की दिशा में विकास करें। वर्तमान में, उच्च-वोल्टेज, उच्च-शक्ति और उच्च-आवृत्ति सिलिकॉन कार्बाइड उपकरणों के विकास ने महत्वपूर्ण प्रगति की है, लेकिन उपकरणों की उत्पादन दक्षता और तैयारी लागत उनके विकास को प्रतिबंधित करने वाला एक महत्वपूर्ण कारक बन जाएगी। सब्सट्रेट के रूप में सिलिकॉन कार्बाइड सिंगल क्रिस्टल वाले अर्धचालक उपकरणों में, सब्सट्रेट का मूल्य सबसे बड़ा अनुपात, लगभग 50% होता है। बड़े आकार के उच्च गुणवत्ता वाले सिलिकॉन कार्बाइड क्रिस्टल विकास उपकरण का विकास, सिलिकॉन कार्बाइड सिंगल क्रिस्टल सब्सट्रेट्स की उपज और विकास दर में सुधार, और उत्पादन लागत को कम करना संबंधित उपकरणों के अनुप्रयोग के लिए महत्वपूर्ण महत्व है। उत्पादन क्षमता आपूर्ति बढ़ाने और सिलिकॉन कार्बाइड उपकरणों की औसत लागत को और कम करने के लिए, सिलिकॉन कार्बाइड सब्सट्रेट्स के आकार का विस्तार करना महत्वपूर्ण तरीकों में से एक है। वर्तमान में, अंतरराष्ट्रीय मुख्यधारा सिलिकॉन कार्बाइड सब्सट्रेट का आकार 6 इंच है, और यह तेजी से 8 इंच तक बढ़ रहा है।
8-इंच सिलिकॉन कार्बाइड सिंगल क्रिस्टल ग्रोथ फर्नेस के विकास में जिन मुख्य तकनीकों को हल करने की आवश्यकता है उनमें शामिल हैं: 1) विकास के लिए उपयुक्त छोटे रेडियल तापमान ग्रेडिएंट और एक बड़े अनुदैर्ध्य तापमान ग्रेडिएंट प्राप्त करने के लिए बड़े आकार के थर्मल क्षेत्र संरचना का डिजाइन। 8-इंच सिलिकॉन कार्बाइड क्रिस्टल का। 2) बड़े आकार के क्रूसिबल रोटेशन और कॉइल उठाने और कम करने की गति तंत्र, ताकि क्रूसिबल क्रिस्टल विकास प्रक्रिया के दौरान घूमता है और 8-इंच क्रिस्टल की स्थिरता सुनिश्चित करने और विकास और मोटाई को सुविधाजनक बनाने के लिए प्रक्रिया आवश्यकताओं के अनुसार कॉइल के सापेक्ष चलता है . 3) गतिशील परिस्थितियों में प्रक्रिया मापदंडों का स्वचालित नियंत्रण जो उच्च गुणवत्ता वाली एकल क्रिस्टल विकास प्रक्रिया की आवश्यकताओं को पूरा करता है।
1 पीवीटी क्रिस्टल विकास तंत्र
पीवीटी विधि एक बेलनाकार घने ग्रेफाइट क्रूसिबल के नीचे SiC स्रोत को रखकर सिलिकॉन कार्बाइड एकल क्रिस्टल तैयार करना है, और SiC बीज क्रिस्टल को क्रूसिबल कवर के पास रखा जाता है। क्रूसिबल को रेडियो फ्रीक्वेंसी इंडक्शन या प्रतिरोध द्वारा 2 300 ~ 2 400 ℃ तक गर्म किया जाता है, और ग्रेफाइट फेल्ट या द्वारा इन्सुलेट किया जाता हैझरझरा ग्रेफाइट. SiC स्रोत से बीज क्रिस्टल तक पहुंचाए जाने वाले मुख्य पदार्थ Si, Si2C अणु और SiC2 हैं। बीज क्रिस्टल पर तापमान को निचले माइक्रो-पाउडर की तुलना में थोड़ा कम नियंत्रित किया जाता है, और क्रूसिबल में एक अक्षीय तापमान प्रवणता बनाई जाती है। जैसा कि चित्र 1 में दिखाया गया है, सिलिकॉन कार्बाइड माइक्रो-पाउडर विभिन्न गैस चरण घटकों की प्रतिक्रिया गैसों को बनाने के लिए उच्च तापमान पर उर्ध्वपातित होता है, जो तापमान प्रवणता के तहत कम तापमान के साथ बीज क्रिस्टल तक पहुंचता है और उस पर क्रिस्टलीकृत होकर एक बेलनाकार बनता है। सिलिकॉन कार्बाइड पिंड.
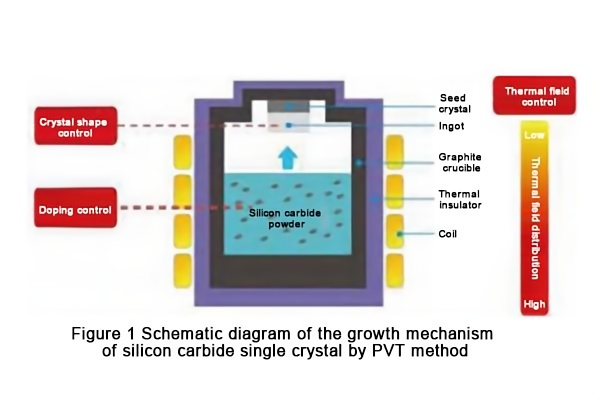
पीवीटी वृद्धि की मुख्य रासायनिक प्रतिक्रियाएँ हैं:
SiC(s)⇌Si(g)+C(s) (1)
2SiC⇌Si2C(g)+C(s) (2)
2SiC⇌SiC2(g)+Si(l,g) (3)
SiC(s)⇌SiC(g) (4)
SiC एकल क्रिस्टल की PVT वृद्धि की विशेषताएं हैं:
1) दो गैस-ठोस इंटरफ़ेस हैं: एक गैस-SiC पाउडर इंटरफ़ेस है, और दूसरा गैस-क्रिस्टल इंटरफ़ेस है।
2) गैस चरण दो प्रकार के पदार्थों से बना है: एक सिस्टम में पेश किए गए निष्क्रिय अणु हैं; दूसरा गैस चरण घटक SimCn है जो अपघटन और उर्ध्वपातन द्वारा निर्मित होता हैSiC पाउडर. गैस चरण घटक SimCn एक दूसरे के साथ बातचीत करते हैं, और तथाकथित क्रिस्टलीय गैस चरण घटक SimCn का एक हिस्सा जो क्रिस्टलीकरण प्रक्रिया की आवश्यकताओं को पूरा करता है वह SiC क्रिस्टल में विकसित होगा।
3) ठोस सिलिकॉन कार्बाइड पाउडर में, ठोस-चरण प्रतिक्रियाएं उन कणों के बीच होंगी जो उर्ध्वपातित नहीं हुए हैं, जिनमें कुछ कण सिंटरिंग के माध्यम से छिद्रपूर्ण सिरेमिक बॉडी बनाते हैं, कुछ कण क्रिस्टलीकरण प्रतिक्रियाओं के माध्यम से एक निश्चित कण आकार और क्रिस्टलोग्राफिक आकारिकी के साथ अनाज बनाते हैं, और कुछ गैर-स्टोइकोमेट्रिक अपघटन और उर्ध्वपातन के कारण सिलिकॉन कार्बाइड कण कार्बन-समृद्ध कणों या कार्बन कणों में परिवर्तित हो जाते हैं।
4) क्रिस्टल विकास प्रक्रिया के दौरान, दो चरण परिवर्तन होंगे: एक यह है कि ठोस सिलिकॉन कार्बाइड पाउडर कण गैर-स्टोइकोमेट्रिक अपघटन और उर्ध्वपातन के माध्यम से गैस चरण घटकों SimCn में परिवर्तित हो जाते हैं, और दूसरा यह है कि गैस चरण घटक SimCn परिवर्तित हो जाते हैं क्रिस्टलीकरण के माध्यम से जाली कणों में।
2 उपकरण डिजाइन जैसा कि चित्र 2 में दिखाया गया है, सिलिकॉन कार्बाइड सिंगल क्रिस्टल ग्रोथ फर्नेस में मुख्य रूप से शामिल हैं: ऊपरी कवर असेंबली, चैम्बर असेंबली, हीटिंग सिस्टम, क्रूसिबल रोटेशन मैकेनिज्म, लोअर कवर लिफ्टिंग मैकेनिज्म और इलेक्ट्रिकल कंट्रोल सिस्टम।

2.1 हीटिंग सिस्टम जैसा कि चित्र 3 में दिखाया गया है, हीटिंग सिस्टम इंडक्शन हीटिंग को अपनाता है और एक इंडक्शन कॉइल से बना होता है, एकग्रेफाइट क्रूसिबल, एक इन्सुलेशन परत(कठोर महसूस हुआ, नरम महसूस हुआ), आदि। जब मध्यम आवृत्ति की प्रत्यावर्ती धारा ग्रेफाइट क्रूसिबल के बाहर के आसपास मल्टी-टर्न इंडक्शन कॉइल से होकर गुजरती है, तो उसी आवृत्ति का एक प्रेरित चुंबकीय क्षेत्र ग्रेफाइट क्रूसिबल में बनेगा, जिससे एक प्रेरित इलेक्ट्रोमोटिव बल उत्पन्न होगा। चूंकि उच्च शुद्धता वाले ग्रेफाइट क्रूसिबल पदार्थ में अच्छी चालकता होती है, क्रूसिबल दीवार पर एक प्रेरित धारा उत्पन्न होती है, जिससे एक भंवर धारा बनती है। लोरेंत्ज़ बल की कार्रवाई के तहत, प्रेरित धारा अंततः क्रूसिबल की बाहरी दीवार (यानी, त्वचा प्रभाव) पर एकत्रित हो जाएगी और रेडियल दिशा के साथ धीरे-धीरे कमजोर हो जाएगी। एड़ी धाराओं के अस्तित्व के कारण, क्रूसिबल की बाहरी दीवार पर जूल गर्मी उत्पन्न होती है, जो विकास प्रणाली का ताप स्रोत बन जाती है। जूल ऊष्मा का आकार और वितरण सीधे क्रूसिबल में तापमान क्षेत्र को निर्धारित करता है, जो बदले में क्रिस्टल के विकास को प्रभावित करता है।
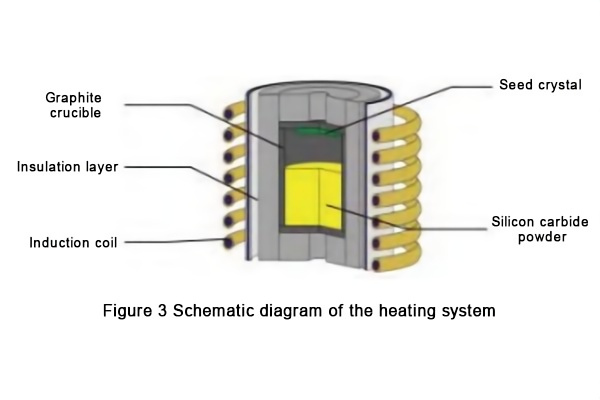
जैसा कि चित्र 4 में दिखाया गया है, इंडक्शन कॉइल हीटिंग सिस्टम का एक महत्वपूर्ण हिस्सा है। यह स्वतंत्र कुंडल संरचनाओं के दो सेटों को अपनाता है और क्रमशः ऊपरी और निचले परिशुद्धता गति तंत्र से सुसज्जित है। पूरे हीटिंग सिस्टम की अधिकांश विद्युत ताप हानि कॉइल द्वारा वहन की जाती है, और मजबूर शीतलन किया जाना चाहिए। कुंडल को तांबे की ट्यूब से लपेटा जाता है और अंदर पानी से ठंडा किया जाता है। प्रेरित धारा की आवृत्ति सीमा 8~12 kHz है। प्रेरण हीटिंग की आवृत्ति ग्रेफाइट क्रूसिबल में विद्युत चुम्बकीय क्षेत्र की प्रवेश गहराई निर्धारित करती है। कुंडल गति तंत्र मोटर चालित पेंच जोड़ी तंत्र का उपयोग करता है। इंडक्शन कॉइल पाउडर के उर्ध्वपातन को प्राप्त करने के लिए आंतरिक ग्रेफाइट क्रूसिबल को गर्म करने के लिए इंडक्शन बिजली आपूर्ति के साथ सहयोग करता है। साथ ही, कॉइल के दो सेटों की शक्ति और सापेक्ष स्थिति को बीज क्रिस्टल पर तापमान को निचले माइक्रो-पाउडर की तुलना में कम करने के लिए नियंत्रित किया जाता है, जिससे बीज क्रिस्टल और पाउडर के बीच एक अक्षीय तापमान ढाल बनता है। क्रूसिबल, और सिलिकॉन कार्बाइड क्रिस्टल पर एक उचित रेडियल तापमान प्रवणता बनाता है।

2.2 बड़े आकार की वृद्धि के दौरान क्रूसिबल रोटेशन तंत्रसिलिकॉन कार्बाइड एकल क्रिस्टल, गुहा के निर्वात वातावरण में क्रूसिबल को प्रक्रिया की आवश्यकताओं के अनुसार घुमाया जाता है, और ढाल थर्मल क्षेत्र और गुहा में कम दबाव की स्थिति को स्थिर रखने की आवश्यकता होती है। जैसा कि चित्र 5 में दिखाया गया है, क्रूसिबल के स्थिर घुमाव को प्राप्त करने के लिए मोटर चालित गियर जोड़ी का उपयोग किया जाता है। घूर्णन शाफ्ट की गतिशील सीलिंग प्राप्त करने के लिए एक चुंबकीय द्रव सीलिंग संरचना का उपयोग किया जाता है। चुंबकीय द्रव सील चुंबक, चुंबकीय ध्रुव जूता और चुंबकीय आस्तीन के बीच गठित एक घूर्णन चुंबकीय क्षेत्र सर्किट का उपयोग करता है ताकि ध्रुव जूता टिप और आस्तीन के बीच चुंबकीय तरल को मजबूती से सोख लिया जा सके ताकि ओ-रिंग जैसी तरल अंगूठी बनाई जा सके, जो पूरी तरह से अवरुद्ध हो। सीलिंग के उद्देश्य को प्राप्त करने के लिए अंतर। जब घूर्णी गति वायुमंडल से निर्वात कक्ष में प्रसारित होती है, तो तरल ओ-रिंग गतिशील सीलिंग डिवाइस का उपयोग ठोस सीलिंग में आसान पहनने और कम जीवन के नुकसान को दूर करने के लिए किया जाता है, और तरल चुंबकीय तरल पदार्थ पूरे सीलबंद स्थान को भर सकता है, जिससे हवा लीक करने वाले सभी चैनलों को अवरुद्ध किया जा सके और क्रूसिबल मूवमेंट और रुकने की दो प्रक्रियाओं में शून्य रिसाव प्राप्त किया जा सके। चुंबकीय तरल पदार्थ और क्रूसिबल समर्थन चुंबकीय तरल पदार्थ और क्रूसिबल समर्थन की उच्च तापमान प्रयोज्यता सुनिश्चित करने और थर्मल क्षेत्र की स्थिति की स्थिरता प्राप्त करने के लिए जल-शीतलन संरचना को अपनाते हैं।

2.3 निचला कवर उठाने की व्यवस्था
निचले कवर उठाने वाले तंत्र में एक ड्राइव मोटर, एक बॉल स्क्रू, एक रैखिक गाइड, एक उठाने वाला ब्रैकेट, एक फर्नेस कवर और एक फर्नेस कवर ब्रैकेट होता है। निचले कवर के ऊपर और नीचे की गति का एहसास करने के लिए मोटर एक रिड्यूसर के माध्यम से स्क्रू गाइड जोड़ी से जुड़े फर्नेस कवर ब्रैकेट को चलाती है।
निचला कवर उठाने वाला तंत्र बड़े आकार के क्रूसिबल को रखने और हटाने की सुविधा प्रदान करता है, और इससे भी महत्वपूर्ण बात यह है कि निचले भट्टी कवर की सीलिंग विश्वसनीयता सुनिश्चित करता है। पूरी प्रक्रिया के दौरान, चैम्बर में वैक्यूम, उच्च दबाव और निम्न दबाव जैसे दबाव परिवर्तन चरण होते हैं। निचले कवर की संपीड़न और सीलिंग स्थिति सीधे प्रक्रिया की विश्वसनीयता को प्रभावित करती है। एक बार जब सील उच्च तापमान के तहत विफल हो जाती है, तो पूरी प्रक्रिया रद्द कर दी जाएगी। मोटर सर्वो नियंत्रण और सीमा उपकरण के माध्यम से, प्रक्रिया दबाव की स्थिरता सुनिश्चित करने के लिए भट्ठी कक्ष सीलिंग रिंग के संपीड़न और सीलिंग की सर्वोत्तम स्थिति प्राप्त करने के लिए निचले कवर असेंबली और कक्ष की जकड़न को नियंत्रित किया जाता है, जैसा कि चित्र 6 में दिखाया गया है। .
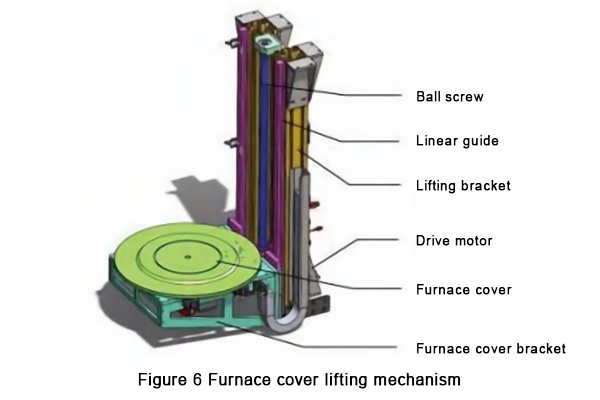
2.4 विद्युत नियंत्रण प्रणाली सिलिकॉन कार्बाइड क्रिस्टल की वृद्धि के दौरान, विद्युत नियंत्रण प्रणाली को विभिन्न प्रक्रिया मापदंडों को सटीक रूप से नियंत्रित करने की आवश्यकता होती है, जिसमें मुख्य रूप से कुंडल स्थिति ऊंचाई, क्रूसिबल रोटेशन दर, ताप शक्ति और तापमान, विभिन्न विशेष गैस सेवन प्रवाह और उद्घाटन शामिल हैं। आनुपातिक वाल्व.
जैसा कि चित्र 7 में दिखाया गया है, नियंत्रण प्रणाली एक सर्वर के रूप में एक प्रोग्रामयोग्य नियंत्रक का उपयोग करती है, जो कॉइल और क्रूसिबल के गति नियंत्रण का एहसास करने के लिए बस के माध्यम से सर्वो चालक से जुड़ा होता है; यह तापमान, दबाव और विशेष प्रक्रिया गैस प्रवाह के वास्तविक समय नियंत्रण का एहसास करने के लिए मानक MobusRTU के माध्यम से तापमान नियंत्रक और प्रवाह नियंत्रक से जुड़ा हुआ है। यह ईथरनेट के माध्यम से कॉन्फ़िगरेशन सॉफ़्टवेयर के साथ संचार स्थापित करता है, वास्तविक समय में सिस्टम जानकारी का आदान-प्रदान करता है, और होस्ट कंप्यूटर पर विभिन्न प्रक्रिया पैरामीटर जानकारी प्रदर्शित करता है। ऑपरेटर, प्रक्रिया कर्मी और प्रबंधक मानव-मशीन इंटरफ़ेस के माध्यम से नियंत्रण प्रणाली के साथ सूचनाओं का आदान-प्रदान करते हैं।

नियंत्रण प्रणाली सभी फ़ील्ड डेटा संग्रह, सभी एक्चुएटर्स की परिचालन स्थिति का विश्लेषण और तंत्र के बीच तार्किक संबंध का प्रदर्शन करती है। प्रोग्राम करने योग्य नियंत्रक होस्ट कंप्यूटर के निर्देश प्राप्त करता है और सिस्टम के प्रत्येक एक्चुएटर का नियंत्रण पूरा करता है। स्वचालित प्रक्रिया मेनू का निष्पादन और सुरक्षा रणनीति सभी प्रोग्रामयोग्य नियंत्रक द्वारा क्रियान्वित की जाती है। प्रोग्रामयोग्य नियंत्रक की स्थिरता प्रक्रिया मेनू संचालन की स्थिरता और सुरक्षा विश्वसनीयता सुनिश्चित करती है।
ऊपरी कॉन्फ़िगरेशन वास्तविक समय में प्रोग्रामयोग्य नियंत्रक के साथ डेटा विनिमय बनाए रखता है और फ़ील्ड डेटा प्रदर्शित करता है। यह हीटिंग नियंत्रण, दबाव नियंत्रण, गैस सर्किट नियंत्रण और मोटर नियंत्रण जैसे ऑपरेशन इंटरफेस से सुसज्जित है, और इंटरफ़ेस पर विभिन्न मापदंडों के सेटिंग मानों को संशोधित किया जा सकता है। अलार्म मापदंडों की वास्तविक समय की निगरानी, स्क्रीन अलार्म डिस्प्ले प्रदान करना, अलार्म घटना और पुनर्प्राप्ति का समय और विस्तृत डेटा रिकॉर्ड करना। सभी प्रक्रिया डेटा, स्क्रीन संचालन सामग्री और संचालन समय की वास्तविक समय रिकॉर्डिंग। विभिन्न प्रक्रिया मापदंडों का संलयन नियंत्रण प्रोग्रामयोग्य नियंत्रक के अंदर अंतर्निहित कोड के माध्यम से महसूस किया जाता है, और प्रक्रिया के अधिकतम 100 चरणों को महसूस किया जा सकता है। प्रत्येक चरण में एक दर्जन से अधिक प्रक्रिया पैरामीटर शामिल होते हैं जैसे प्रक्रिया संचालन समय, लक्ष्य शक्ति, लक्ष्य दबाव, आर्गन प्रवाह, नाइट्रोजन प्रवाह, हाइड्रोजन प्रवाह, क्रूसिबल स्थिति और क्रूसिबल दर।
3 थर्मल फील्ड सिमुलेशन विश्लेषण
थर्मल फील्ड सिमुलेशन विश्लेषण मॉडल स्थापित किया गया है। चित्र 8 क्रूसिबल विकास कक्ष में तापमान बादल मानचित्र है। 4H-SiC सिंगल क्रिस्टल की वृद्धि तापमान सीमा सुनिश्चित करने के लिए, बीज क्रिस्टल के केंद्र का तापमान 2200℃ और किनारे का तापमान 2205.4℃ की गणना की जाती है। इस समय, क्रूसिबल शीर्ष का केंद्र तापमान 2167.5 ℃ है, और पाउडर क्षेत्र (नीचे की ओर) का उच्चतम तापमान 2274.4 ℃ है, जो एक अक्षीय तापमान ढाल बनाता है।

क्रिस्टल का रेडियल ग्रेडिएंट वितरण चित्र 9 में दिखाया गया है। बीज क्रिस्टल सतह का निचला पार्श्व तापमान ग्रेडिएंट क्रिस्टल विकास आकार को प्रभावी ढंग से सुधार सकता है। वर्तमान गणना प्रारंभिक तापमान अंतर 5.4 ℃ है, और समग्र आकार लगभग सपाट और थोड़ा उत्तल है, जो बीज क्रिस्टल सतह की रेडियल तापमान नियंत्रण सटीकता और एकरूपता आवश्यकताओं को पूरा कर सकता है।

कच्चे माल की सतह और बीज क्रिस्टल सतह के बीच तापमान अंतर वक्र चित्र 10 में दिखाया गया है। सामग्री की सतह का केंद्र तापमान 2210 ℃ है, और 1 ℃ / सेमी का एक अनुदैर्ध्य तापमान ढाल सामग्री की सतह और बीज के बीच बनता है क्रिस्टल सतह, जो एक उचित सीमा के भीतर है।
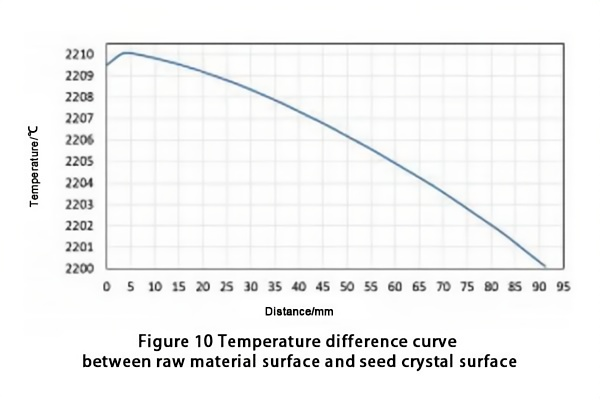
अनुमानित विकास दर चित्र 11 में दिखाई गई है। बहुत तेज़ विकास दर बहुरूपता और अव्यवस्था जैसे दोषों की संभावना को बढ़ा सकती है। वर्तमान अनुमानित वृद्धि दर 0.1 मिमी/घंटा के करीब है, जो एक उचित सीमा के भीतर है।

थर्मल फील्ड सिमुलेशन विश्लेषण और गणना के माध्यम से, यह पाया गया कि बीज क्रिस्टल का केंद्र तापमान और किनारे का तापमान 8 इंच के क्रिस्टल के रेडियल तापमान ढाल से मिलता है। साथ ही, क्रूसिबल के ऊपर और नीचे क्रिस्टल की लंबाई और मोटाई के लिए उपयुक्त एक अक्षीय तापमान ढाल बनाते हैं। विकास प्रणाली की वर्तमान हीटिंग विधि 8-इंच एकल क्रिस्टल के विकास को पूरा कर सकती है।
4 प्रायोगिक परीक्षण
इसका उपयोग कर रहे हैंसिलिकॉन कार्बाइड सिंगल क्रिस्टल ग्रोथ फर्नेसथर्मल फील्ड सिमुलेशन के तापमान ढाल के आधार पर, क्रूसिबल शीर्ष तापमान, गुहा दबाव, क्रूसिबल रोटेशन गति और ऊपरी और निचले कॉइल्स की सापेक्ष स्थिति जैसे मापदंडों को समायोजित करके, एक सिलिकॉन कार्बाइड क्रिस्टल विकास परीक्षण किया गया था , और एक 8 इंच का सिलिकॉन कार्बाइड क्रिस्टल प्राप्त हुआ (जैसा चित्र 12 में दिखाया गया है)।

5। उपसंहार
8-इंच सिलिकॉन कार्बाइड सिंगल क्रिस्टल के विकास के लिए प्रमुख तकनीकों, जैसे ग्रेडिएंट थर्मल फील्ड, क्रूसिबल मोशन मैकेनिज्म और प्रक्रिया मापदंडों के स्वचालित नियंत्रण का अध्ययन किया गया। आदर्श तापमान प्रवणता प्राप्त करने के लिए क्रूसिबल ग्रोथ चैंबर में थर्मल क्षेत्र का अनुकरण और विश्लेषण किया गया था। परीक्षण के बाद, डबल-कॉइल इंडक्शन हीटिंग विधि बड़े आकार के विकास को पूरा कर सकती हैसिलिकॉन कार्बाइड क्रिस्टल. इस तकनीक का अनुसंधान और विकास 8-इंच कार्बाइड क्रिस्टल प्राप्त करने के लिए उपकरण प्रौद्योगिकी प्रदान करता है, और 6 इंच से 8 इंच तक सिलिकॉन कार्बाइड औद्योगीकरण के संक्रमण के लिए उपकरण आधार प्रदान करता है, जिससे सिलिकॉन कार्बाइड सामग्री की विकास दक्षता में सुधार होता है और लागत कम होती है।



