
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
CVD TaC कोटिंग कैसे तैयार करें?
2024-08-23
CVD TaC कोटिंगउच्च शक्ति, संक्षारण प्रतिरोध और अच्छी रासायनिक स्थिरता के साथ एक महत्वपूर्ण उच्च तापमान संरचनात्मक सामग्री है। इसका गलनांक 3880℃ जितना ऊँचा है, और यह उच्चतम तापमान प्रतिरोधी यौगिकों में से एक है। इसमें उत्कृष्ट उच्च तापमान यांत्रिक गुण, उच्च गति वायु प्रवाह क्षरण प्रतिरोध, पृथक्करण प्रतिरोध, और ग्रेफाइट और कार्बन/कार्बन मिश्रित सामग्री के साथ अच्छी रासायनिक और यांत्रिक संगतता है।
इसलिए, मेंMOCVD एपिटैक्सियल प्रक्रियाGaNLEDs और Sic बिजली उपकरणों की,CVD TaC कोटिंगइसमें H2, HC1 और NH3 के लिए उत्कृष्ट एसिड और क्षार प्रतिरोध है, जो ग्रेफाइट मैट्रिक्स सामग्री की पूरी तरह से रक्षा कर सकता है और विकास पर्यावरण को शुद्ध कर सकता है।
CVD TaC कोटिंग अभी भी 2000 ℃ से ऊपर स्थिर है, और CVD TaC कोटिंग 1200-1400 ℃ पर विघटित होना शुरू हो जाती है, जिससे ग्रेफाइट मैट्रिक्स की अखंडता में भी काफी सुधार होगा। सभी बड़े संस्थान ग्रेफाइट सब्सट्रेट पर सीवीडी टीएसी कोटिंग तैयार करने के लिए सीवीडी का उपयोग करते हैं, और सीआईसी बिजली उपकरणों और GaNLEDS एपिटैक्सियल उपकरणों की जरूरतों को पूरा करने के लिए सीवीडी टीएसी कोटिंग की उत्पादन क्षमता को और बढ़ाएंगे।
सीवीडी टीएसी कोटिंग की तैयारी प्रक्रिया आम तौर पर सब्सट्रेट सामग्री के रूप में उच्च घनत्व ग्रेफाइट का उपयोग करती है, और दोष मुक्त तैयार करती हैCVD TaC कोटिंगसीवीडी विधि द्वारा ग्रेफाइट सतह पर।
सीवीडी टीएसी कोटिंग तैयार करने के लिए सीवीडी विधि की प्राप्ति प्रक्रिया इस प्रकार है: वाष्पीकरण कक्ष में रखा गया ठोस टैंटलम स्रोत एक निश्चित तापमान पर गैस में परिवर्तित हो जाता है, और अर वाहक गैस की एक निश्चित प्रवाह दर द्वारा वाष्पीकरण कक्ष से बाहर ले जाया जाता है। एक निश्चित तापमान पर, गैसीय टैंटलम स्रोत एक कमी प्रतिक्रिया से गुजरने के लिए हाइड्रोजन से मिलता है और मिश्रित होता है। अंत में, कम टैंटलम तत्व को जमाव कक्ष में ग्रेफाइट सब्सट्रेट की सतह पर जमा किया जाता है, और एक निश्चित तापमान पर कार्बोनाइजेशन प्रतिक्रिया होती है।
सीवीडी टीएसी कोटिंग की प्रक्रिया में वाष्पीकरण तापमान, गैस प्रवाह दर और जमाव तापमान जैसे प्रक्रिया पैरामीटर इसके निर्माण में बहुत महत्वपूर्ण भूमिका निभाते हैं।CVD TaC कोटिंग.
मिश्रित अभिविन्यास के साथ सीवीडी TaC कोटिंग TaCl5-H2-Ar-C3H6 प्रणाली का उपयोग करके 1800 डिग्री सेल्सियस पर आइसोथर्मल रासायनिक वाष्प जमाव द्वारा तैयार की गई थी।
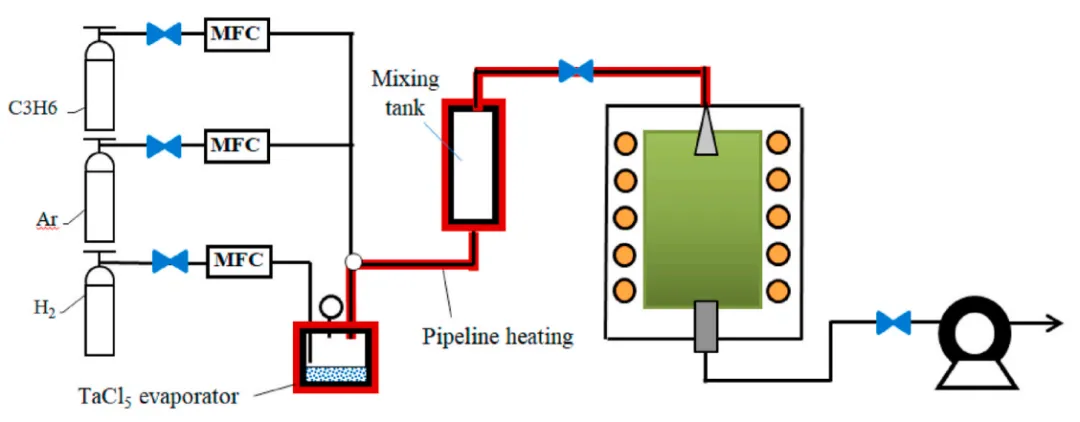
चित्र 1 रासायनिक वाष्प जमाव (सीवीडी) रिएक्टर और TaC जमाव के लिए संबंधित गैस वितरण प्रणाली के विन्यास को दर्शाता है।
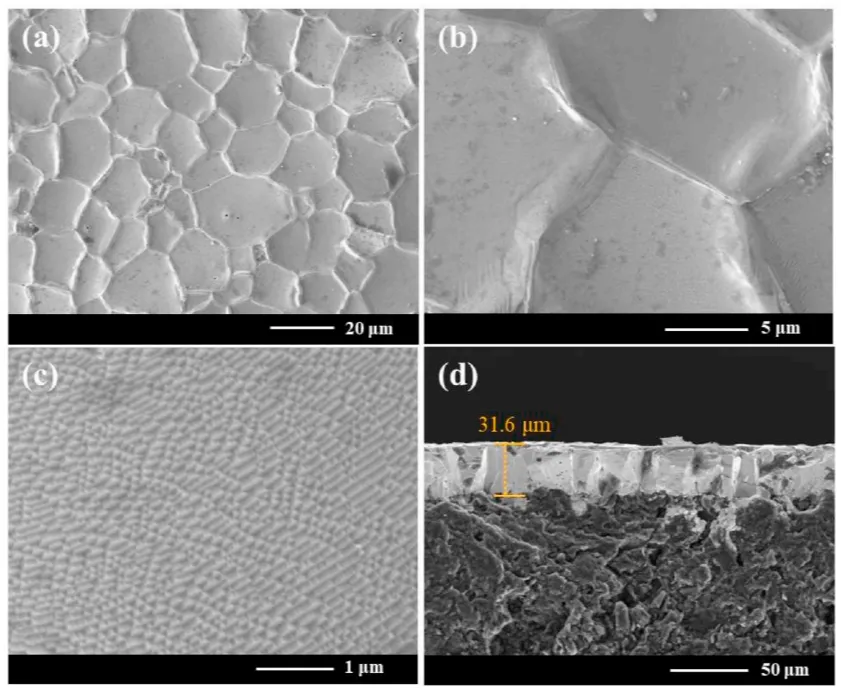
चित्र 2 विभिन्न आवर्धन पर सीवीडी टीएसी कोटिंग की सतह आकृति विज्ञान को दर्शाता है, जो कोटिंग के घनत्व और अनाज की आकृति विज्ञान को दर्शाता है।

चित्र 3 केंद्रीय क्षेत्र में पृथक्करण के बाद सीवीडी टीएसी कोटिंग की सतह आकृति विज्ञान को दर्शाता है, जिसमें धुंधली अनाज की सीमाएं और सतह पर बने द्रव पिघले हुए ऑक्साइड शामिल हैं।

चित्र 4 एब्लेशन के बाद विभिन्न क्षेत्रों में सीवीडी टीएसी कोटिंग के एक्सआरडी पैटर्न दिखाता है, एब्लेशन उत्पादों की चरण संरचना का विश्लेषण करता है, जो मुख्य रूप से β-Ta2O5 और α-Ta2O5 हैं।



